成果展示
微电子所在传感器晶圆级键合封装技术研究中取得重要进展
近日,微电子所集成电路先导工艺研发中心(十室)在传感器晶圆级键合封装技术研发领域取得重要进展,其针对三轴加速度传感器所开发的8英寸Al-Ge共晶圆片级封装技术(WLP)以及配套的减薄和划片技术已通过苏州明皜传感科技有限公司的质量体系考核,采用该系列技术的T4型三轴加速度产品已上市销售。
MEMS器件与传统IC器件相比,往往具有脆弱的可动结构,因此需要在MEMS器件划片与测试前将其保护起来。WLP技术在大大降低器件尺寸与成本的同时,还可有效地提高器件生产良率与可靠性,因此针对MEMS器件的WLP技术已成为科技界与工业界的关注热点。MEMS器件的WLP技术不仅需要提供必需的焊盘引出外,还要担负起为器件可动结构提供适当的气密或真空等工作环境的任务,因此相对传统IC,MEMS对WLP技术提出更高的技术挑战。
集成电路先导工艺研发中心(十室)与江苏艾特曼电子科技有限公司共同建立了微电子所晶圆键合联合实验室,致力于MEMS器件的晶圆级键合封装技术的开发。该实验室开发的第一套Al-Ge晶圆键合封装技术的键合环宽度仅有70um,其键合强度已超过70MPa、漏率小于5.0x10-3Pa·cm³/s,该产品FT成品率高于97%,与国际知名半导体代工厂所生产的同类产品指标相当,达到国际一流水平。
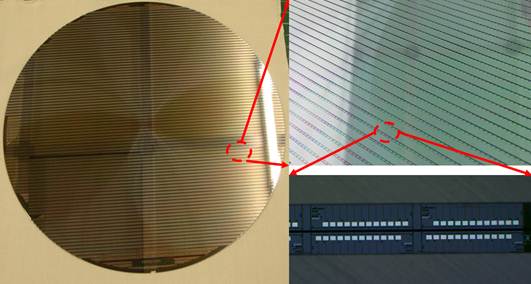
完成代工后产出晶圆照片
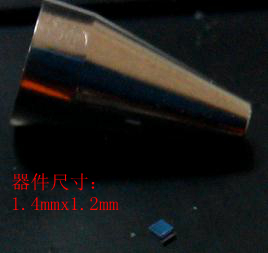
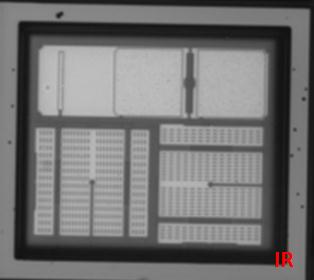
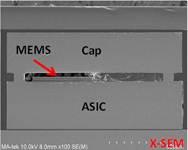
最终切割后产品照片以及红外、X-SEM

