成果展示
微电子所在氮化镓增强型MIS-HEMT研究方面取得重要进展
近日,微电子所氮化镓(GaN)功率电子器件研究团队与香港科技大学陈敬教授团队、西安电子科技大学郝跃院士团队合作,在GaN增强型MIS-HEMT器件研制方面取得重要进展,成功研制出具有国际先进水平的高频增强型GaN MIS-HEMT器件。
第三代半导体材料氮化镓具有高禁带宽度、高击穿电场、高饱和电子漂移速度等优异的物理性质,尤其是材料本身的强自发和压电极化效应能在AlGaN/GaN异质结构中诱导出高密度、高迁移率的二维电子气(迁移率可达到2000 cm2/V·s以上),突破了传统Si基功率器件的材料极限。这些优良性质促使GaN功率电子器件在工作频率和电能转换效率上脱颖而出,成为下一代高效节能功率电子器件的最佳候选之一。
增强型,也叫常关型,是电力电子应用的关键要求,其中栅槽刻蚀工艺是最早实现GaN增强型器件的技术之一。传统的刻蚀工艺主要在常温下进行,无法实现刻蚀所造成的晶格损伤的原位恢复和刻蚀残留物的及时清除,造成器件输出电流的急剧降低,成为制约该技术在GaN功率电子领域的应用瓶颈。微电子所GaN功率电子器件研究团队通过耐高温刻蚀掩模技术,创新性地采用高温栅槽刻蚀工艺显著降低对沟道二维电子气的损伤,提高了刻蚀残留物的挥发。同时采用自主研制的臭氧辅助原子层沉积技术,制备出高绝缘、低缺陷的Al2O3栅介质,有效抑制了栅极漏电流。结合以上两项创新(如图1所示),最终研制出阈值电压+1.6V,脉冲输出电流高达1.13A/mm,关态功耗仅为6×10-8 W/mm的GaN增强型MIS-HEMT器件。相对于常温刻蚀制备的MIS-HEMT器件(输出电流0.42A/mm),高温刻蚀输出电流提高了将近两倍(如图2(a)和(b)所示)。
该增强型MIS-HEMT器件在4GHz下的脉冲输出功率达到5.76 W/mm,功率附加效率57%,高于国际上报道的阈值电压超过+1.5V MIS-HEMT器件的功率性能(如图2(c)所示)。该增强型GaN MIS-HEMT的成功研制突破了栅槽刻蚀技术制备GaN功率电子器件的瓶颈,为进一步提高氮化镓电子器件的工作频率(10 MHz以上)和转换效率奠定了扎实基础。
该项目得到国家自然科学基金和香港政府创新技术基金的资助。研究成果在半导体研究领域权威网站Semiconductor TODAY上报道并被中科院英文网站转载,即将发表于2015年8月的IEEE Electron Device Letters(http://dx.doi.org/10.1109/LED.2015.2445353)。
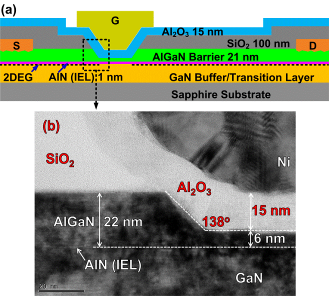
图1 (a)研制的GaN增强型MIS-HEMT结构;(b)器件栅极TEM剖面图

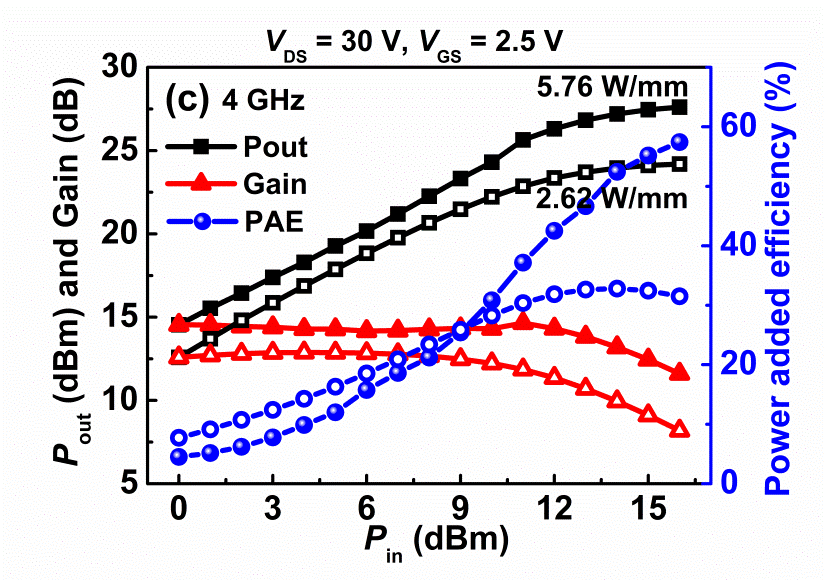
图2 (a)常温刻蚀MIS-HEMT器件脉冲输出性能;(b)高温刻蚀MIS-HEMT器件脉冲输出性能;(c)高温刻蚀MIS-HEMT器件RF功率性能
相关新闻链接:
-
Semiconductor TODAY: http://www.semiconductor-today.com/news_items/2015/jul/hkust_080715.shtml
-
Chinese Academy of Sciences: http://english.cas.cn/newsroom/research_news/201507/t20150709_150066.shtml

