成果展示
微电子所14纳米CMOS量产工艺中光源掩模协同优化技术研发取得显著进展
近日,微电子所先导中心韦亚一研究员团队与中芯国际研究团队围绕14纳米CMOS量产工艺中光源掩模协同优化技术开展联合攻关并取得显著进展,完成了后段制程中多层关键层的光源优化工作,包括Metal 1X、Metal 1.25X、Via 1X等。优化后光源通过晶圆数据验证评估,较原有光源在各项关键指标上有显著提升,保证了先进节点中光刻工艺的稳定性,确保后续研发进程的顺利进行。
SMO技术是14纳米及以下技术节点必不可少的一项分辨率增强技术,针对特定层的设计规则、掩模结构、光刻胶层属性和结构等,根据光学模型对光源形状、强度分布和掩模形状进行同时优化,以获得具有最大光刻工艺窗口的定制型光源和修正后的掩模形状。图1展示的就是一个简单SMO的例子。左图中是光刻的目标图形,经过光源掩模协同优化后获得右图中的修饰后掩模图形和像素化的光源形状,优化后光源能够显著扩展光刻的工艺窗口,提高图形曝光质量,有效控制缺陷的产生,提升良率。
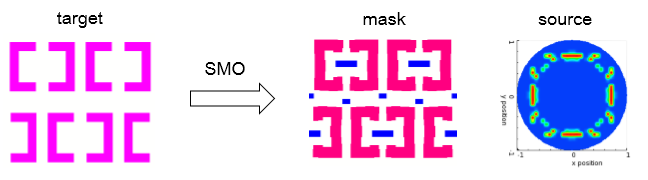
图1 SMO举例
基于该技术,韦亚一团队与中芯国际开展紧密合作,针对各关键层中极限尺寸下的线端对线端、线端对线条、forbidden pitch等难点结构进行联合攻关,提出了有效的解决方案,成功解决了相应结构的光刻难题,有效扩展了当前工艺节点下的分辨率极限。同时,在时间紧、任务重的情况下,采用精简的高斯模型替代复杂的光刻胶模型,在保证仿真精度的前提下,极大缩减了第一轮SMO工作的时间周期,所得仿真结果能够很好地与晶圆数据匹配。晶圆验证结果表明,优化后光源对光刻工艺中的DOF、MEEF、EL、NILS等关键指标有显著提升,单次曝光工艺窗口可达80纳米,曝光容忍度10%以上,光刻分辨率、图形质量、工艺稳定性均达到预期目标,为后续研发工作奠定了坚实的基础。

