
近日,中国科学院微电子所高频高压中心GaN功率电子器件研发团队的2篇论文入选第36届功率半导体器件和集成电路国际会议(ISPSD),其中戴心玥博士的口头报告“An Enhancement-mode AlGaN/GaN HEMT withIsland-Ohmic p-GaN featuring stable thresholdvoltage and large gate swing”荣获大会唯一最佳青年学者奖(ISPSD Charitat Young Researcher Award)。
作为目前主流的增强型商用GaN功率器件,p-GaN栅极HEMT技术路线因具有良好的阈值均匀性受到广泛关注。其中,肖特基接触型p-GaN HEMT器件具有较小的栅极漏电和较大的栅极摆幅,但其存在阈值电压不稳定的问题;欧姆接触型p-GaN HEMT器件(也被称为栅极注入晶体管,Gate injection transistor)尽管具有良好的阈值电压稳定性,但存在显著的栅极漏电问题。戴心玥博士创新提出了一种具有欧姆岛镶嵌的p-GaN栅(Island Ohmic p-GaN gate, 简称IO-PGaN)增强型AlGaN/GaN HEMT器件结构,成功实现了稳定的阈值电压和较大的栅极摆幅。通过定制含有Mg重掺杂盖帽层的外延结构,在欧姆岛顶部实现良好的p型欧姆接触,其余部分为肖特基接触。此外,欧姆岛侧壁的肖特基接触与顶部的欧姆接触可以等效为一个常开型p-FET,当欧姆岛结构足够“窄长”、或欧姆岛结构掺杂浓度足够低时,侧壁耗尽层更易夹断沟道,该等效 p-FET 的阈值电压增大,可实现栅极漏电的自钳位。实验结果表明,该结构继承了肖特基型p-GaN栅器件的低漏电优势和欧姆栅器件良好的阈值稳定性特点,在高栅压和漏压偏置工作条件下均能实现低栅极漏电和稳定的阈值电压,所制备的器件具有较陡峭的亚阈值摆幅。这项研究为提升商用p-GaN栅功率器件的可靠性提供了新的思路,具有重要的应用前景。
团队成员黄怡菲博士在大会上展示了题为 “In-situ Extraction of Time-resolved EOSS on GaN Power Device Based on a Modified Hard Switching Platform”的论文成果。GaN功率器件在高速开关功率变换器中,尤其是硬开关条件下,开关损耗成为总功耗中的主要部分。开关损耗得一部分和器件输出电容COSS损耗(EOSS)有关,体现在COSS中存储的电荷通过2DEG通道的放电过程。该工作提出了一种基于电感负载硬开关评估板的原位测量方法来表征动态EOSS。这种易于实施的方法可以研究EOSS对各种参数的依赖性,包括总线电压、长期关断漏极应力(Pre-HVdrain-stress)和长期硬开关应力(Pre-HSW-stress)。该工作深入揭示了长期应力对EOSS的影响,这有助于评估实际应用中连续硬开关应力条件下GaN功率器件的功率损耗。
以上研究工作得到深圳平湖实验室和中国科学院苏州纳米所的协助,同时得到了国家重点研发计划、国家自然科学基金重点项目、中国科学院-香港裘搓基金重点项目、中国科学院青促会优秀会员和中国科学院微电子所-香港科技大学联合微电子实验室等项目的大力支持。
ISPSD作为IEEE旗下的功率半导体旗舰会议,涵盖功率半导体器件和功率集成电路的设计、工艺、封装和应用等方向,是功率器件领域最具影响力和规模最大的国际学术会议,被认为是该领域的奥林匹克会议,三十多年以来一直都是国际产业界和学术界争相发表重要成果的舞台。

微电子所获奖团队与2023&2024两届ISPSD大会主席合影
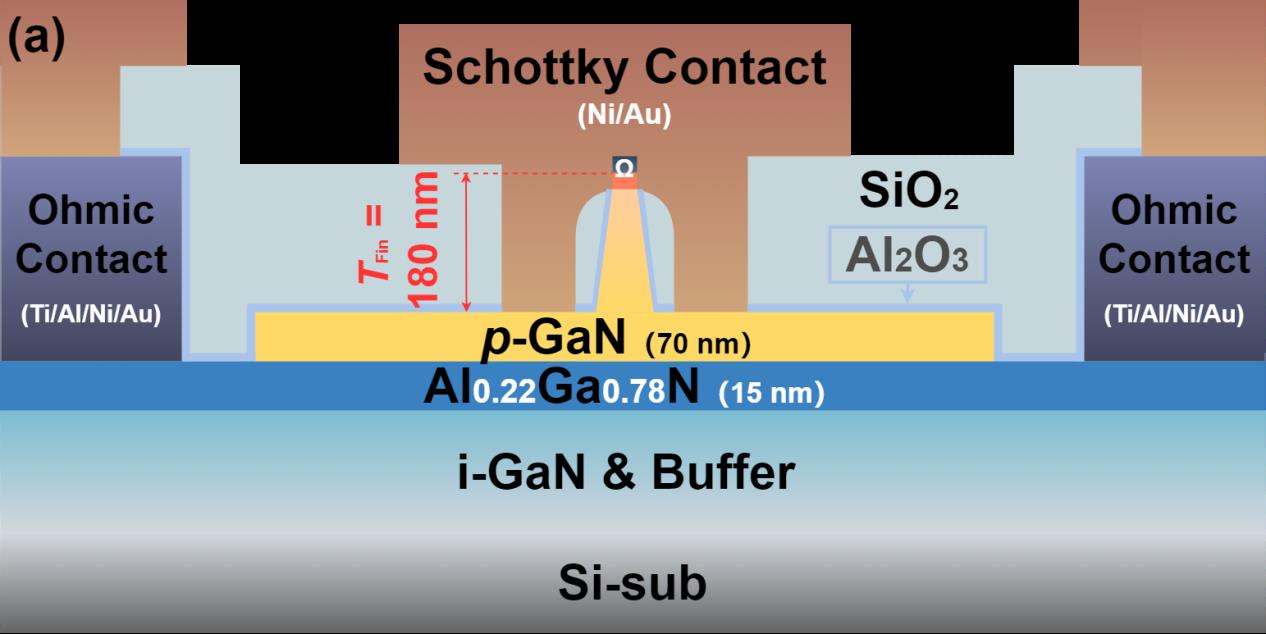
新型欧姆岛状p-GaN栅结构增强型AlGaN/GaN HEMT器件
| 相关新闻: |
| 微电子所在面向存内计算的多比特2T0C DRAM研究中取得重要进展 |
| 微电子所在《中国科学:国家科学评论》发表关于先进CMOS集成电路新结构晶体管的综述论文 |
| 微电子所在全自旋神经形态计算硬件研制及电路实现方面取得新进展 |
综合新闻