MOS界面缺陷工程方向主要围绕MOS器件中的各类界面缺陷问题开展研究,实现器件性能、可靠性的提升以及器件功能维度上的拓展,主要包括(i)缺陷形成的基础理论; (ii)缺陷溯源和表征方法;(iii)缺陷的控制工艺和装备;(iv)基于缺陷工程的新原理器件研制。聚焦一下两个研究方向: (1)基于氧化物半导体(Ga2O3、In2O3等)的晶体管和光电二极管,满足显示、探测等领域的需求;(2) 基于碳基电子材料(SiC、碳纳米管)的新原理器件,满足超低功耗、神经形态计算等需求。
课题组提出同位素示踪、配位场构造、微光波聚能三点创新,打造一条技术链,实现了业内领先的 MOS 界面态和迁移率性能,为我国电力电子器件和高速/低功耗芯片的发展提供了技术支撑,近年来主编英文书系1部、出版学术专著2部、译著1部、发表高水平论文100余篇、申请中外发明专利100余项(授权近50项,对外许可8项)。
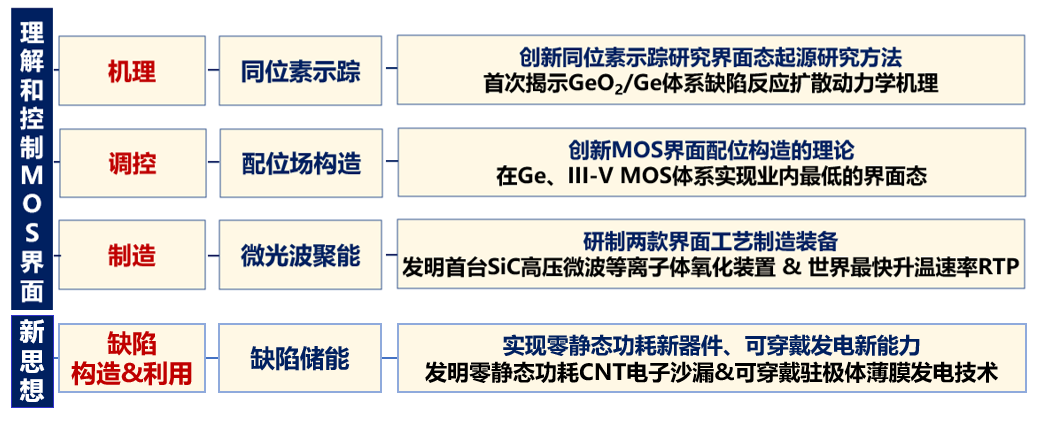
代表成果:
1. Study of defects distribution in SiO2/SiC with plasma oxidation and post oxidation annealing, Applied Surface Science, 610, 155500 (2023).
2. Oxidation Kinetics of SiC in Microwave Oxygen Plasma, Applied Surface Science, 562, 150165 (2021).
3. Demonstration of non-negligible oxygen exchange in the thermal oxidation of silicon carbide, Vacuum, 191, 110403 (2021)
4. Utlizing an SWCNT-TFT “Electronic Hourglass” for Artifical Synapse Application, ACS Applied Electronic Materials, 4, 974 (2022).
高频高压器件与集成研发中心