一、实验室总体介绍:
中国科学院微电子研究所纳米加工与新器件集成技术实验室,拥有从万级到十级超净面积500平方米的纳米加工实验工艺平台,具有丰富的从事纳米加工经验、技术基础和工艺设备的科研支撑能力,在纳米材料制备与纳米加工、纳米材料和性能表征与检测等科学研究和工艺开发方向上具备扎实基础。其中,微光刻与掩模制造研发平台装备有整套光学制版系统:配置美国GCA 3600F Pattern Generator图形发生器、GCA 3696 Photorepeater分步重复精缩机、美国应用材料公司MEBES 4700S电子束掩模曝光系统,是国内最早NGL掩模研制点。同时工艺平台装备了BENEQ TFS200原子层沉积薄膜制备系统、离子束溅射薄膜制备及刻蚀系统、DENTON Explorer14改进型双腔室电子束蒸发镀膜系统、SUSS MA6光学曝光机等先进纳米材料加工设备;以及Horiba Uvisel FUV型号相位调制型椭圆偏振光谱仪、Dektak150台阶仪、低温测试物性表征系统,和一套电学性能测试系统:配置有Keithley 4200SCS/F半导体参数测试系统、直流探针台、探针开关矩阵、脉冲及码型发生器、示波器等。
同时,以纳米加工与新器件集成技术实验室为基础,承载发展了设备先进的电子束光刻技术所级实验平台,目前装备了8纳米束斑的JEOL JBX 5000LS电子束光刻系统,和2纳米束斑的JEOL JBX6300FS电子束光刻系统。
纳米加工与新器件集成技术实验室一方面承担并支撑国家科学研究项目的研究工作;一方面面向全国提供微纳尺度加工技术支持,加工尺寸从微米级到深亚微米、百纳米以至十纳米级,主要服务对象是科研院所、高等院校及国家实验室,甚至国内中小企业用户。其中微光刻与掩模制造研发平台及电子束光刻技术工艺平台拥有遍及国内六十多个城市、香港、台湾及美国、英国、法国、荷兰、日本、韩国、新加坡、俄罗斯等三百多个国内外用户,每年为全国提供2000多个光掩模版制造及其他微纳米加工技术服务,为微电子、微光学、微机械、光电子学、纳米电子学、分子电子束以及生物医学和生物化学等高技术微细图形加工领域提供优质技术服务,涉及范围包括超大规模集成电路、砷化镓场效应等化合物集成电路与器件、C C D 器件、真空微电子学器件、太阳能电池等高效光电子学器件、激光器件、微波器件、超导器件、纳米量子学器件、声表面波器件、人工智能传感器、定向器件、敏感器件、超大规模集成磁泡存储器等特种器件; 波导器件、二元光学器件等集成光学和微光学器件;微机械加工等微机电系统(MEMS&NEMS)的制造技术;以及生物芯片技术、微观激励器、微动泵、微型阀和传感器等典型流体控制元件的生物学微系统制造技术;平面显示技术、液晶显示技术、平面封装技术、位相相移技术、空间滤波技术、波带片应用技术、计算全息编码技术、防伪技术、莫尔技术、定位测量光栅技术和流光溢彩的艺术光栅技术等。
二、设备共享清单:
序号设备名称设备描述共享情况联系人/ 操作员
1JEOL JBX- 6300FS电子束光刻系统(所级实验平台)电子发射源:LaB6;100KV / 50KV / 25KV 三种加速电压;最小束斑2-3nm,极限曝光线条宽度为6-8nm;适用光刻线宽为20-50nm; 电子束束流选择范围为5pA~10nA、套刻精度20-50nm;最大支持6英寸硅片,还可支持碎片和2.5英寸铬版曝光。用在半导体芯片及其他导电样片进行纳米级图形直写曝光,主要应用于百纳米以下的纳米器件和纳米结构曝光。网上预约联系人/操作员:牛洁斌
82995648
2JEOL JBX- 5000LS电子束光刻系统(所级实验平台)电子发射源:LaB6;50KV / 25KV 二种加速电压;最小束斑8nm,极限曝光线条宽度为30nm;适用光刻线宽为90nm;电子束束流选择范围为5pA~10nA、套刻精度40-60nm;最大支持6英寸硅片和5英寸铬版,还可支持碎片曝光;可在半导体芯片及其他导电样片进行纳米级图形直写曝光,主要应用于百纳米以上的微纳米器件和微纳米结构曝光。网上预约联系人/操作员:牛洁斌
82995648
3GCA 3600F Pattern Generator图形发生器最细曝光线宽2um, 精度±0.25 um,加工基片尺寸:2.0英寸;2.5英寸;3.0英寸;4.0英寸;5.0英寸;6.0英寸,主要用于光学掩模版加工。网上预约
(按光学制版系统预约)联系人:李友
82995648
操作员:王冠亚、张卫红、张建宏
4GCA 3696 Photorepeater分步重复精缩机最小曝光分辨率1.25um;定位精度 0.25um;套刻精度 0.25um;最大行程 125mmX125mm;掩模版尺寸2.0英寸;2.5英寸3.0英寸;4.0英寸;5.0英寸;6.0英寸;主要用于光掩模制造与其他微米加工用的工作掩模版曝光。
5MEBES 4700S电子束掩模曝光系统主要用于加工微米级光掩模版,最细曝光图形线宽可达0.6微米,最大掩模版尺寸为6英寸。
6原子层沉积薄膜制备系统反应腔最高加热温度为500℃,温度均匀性为≤±2℃,温度控制精度为±2℃;可加热源最高加热温度为200℃;用于制备薄膜材料,可制备材料有HfO2、Al2O3、TiO2等。网上预约联系人:胡媛82995579
操作员:赵盛杰
新增,请开通仪器操作员帐户
7离子束溅射薄膜制备及刻蚀系统6KW直流离子源,适用于溅射沉积和刻蚀薄膜材料,溅射材料包括:Au、Ti、Cr、Ta、W、Hf、HfO2、ZrO2、TiO2、ZnO2。离子束溅射腔:4个样品盘(其中两个可以加热,加热最高温度700度),适用于4英寸以内晶元片及碎片,腔体最大真空度达到6.6E-5Pa;离子束刻蚀腔:1个样品盘,适用于4英寸以内晶元片及碎片,腔体水冷15度,腔体最大真空度达到6.6E-5Pa。网上预约联系人:胡媛82995579
操作员:刘宇
新增,请开通仪器操作员帐户
8双腔室电子束蒸发镀膜系统极限真空:8×10-8Torr,漏率10mins内优于5×10-5Torr;适用于2英寸、4英寸硅片;4个25cc坩锅;蒸发膜厚范围2nm~1.5μm,适用于铝、铝铜、铝硅、钛、镍、铬、铜、银、金、铂、钨等材料;膜厚均匀性在±3%以内;膜厚重复性在±3%以内。电子束蒸发制备薄膜材料。网上预约联系人:胡媛82995579
操作员:张培文
9光学曝光机基片尺寸:2英寸到4英寸;光源波长:365nm;套刻精度:<1mm;光源均匀性:<5%;可用四种曝光方式(接近、软接触、硬接触、真空复印);对准精度1.5um;最小曝光线宽1um;键合预对准精度3um;正反对准光刻,精度0.8um。用于微纳加工技术中的光学光刻工艺,制备结构和器件。网上预约联系人:胡媛82995579
操作员:田继红
10相位调制型椭圆偏振光谱仪150W氙灯光源,190nm-880nm光谱范围,分辨率好于2nm;光斑尺寸(70°):1×3mm;入射角度:55°到90°,步长5°,角度精确度:±0.05°;主要用于测定薄膜厚度。网上预约联系人:胡媛82995579
操作员:赵盛杰
新增,请开通仪器操作员帐户
11台阶仪测量重复性 6? (10000 ? 标准台阶);最大扫描长度 55mm,用于测量弯曲度和波度;精确 6 英寸样品台(X-Y-Theta 手动定位)可自动测试多重台阶。用于测试微纳结构的台阶高度。 网上预约联系人:胡媛82995579
操作员:田继红
12低温测试物性表征系统真空度:<5×10-4Torr;显微镜分辨率为5um;温度范围:4.2K~400K;探针行程:x=51mm,y=25mm,z=18mm;X轴最小刻度为20um,Y轴最小刻度为10um。主要用于变温(低温)物性测试。直接联系联系人/操作员:余兆安82995582
13电学性能测试系统配置有Keithley 4200SCS/F半导体参数测试系统、直流探针台、探针开关矩阵、脉冲及码型发生器、示波器等。用于测试微电子器件电学特性。直接联系联系人/操作员:余兆安82995582
三、特色仪器设备展示:
设备1:JEOL JBX6300FS电子束光刻系统(所级实验平台)
(一)设备简介
日本电子生产的JEOL JBX6300FS电子束光刻系统,采用热场发射阴极电子发射源,100KV / 50KV / 25KV 三种加速电压,可实现最小电子束束斑为2-3纳米,满足极限分辨率为6-8纳米,适用光刻分辨率为20-50纳米,图形套刻精度20-50纳米。
JEOL JBX6300FS电子束光刻系统主要应用于20-100纳米尺度的纳米结构电子束直写光刻(极限可延伸应用到10纳米),可应用于2英寸、3英寸、4英寸、5英寸晶元片及碎片。
(二)设备应用
JEOL JBX6300FS电子束光刻系统不仅可应用于开展一些基本纳米加工工作,而且运用这种先进纳米加工手段可以支持开展一些纳米结构、器件、电路及系统的研发制备工作。
同时JEOL JBX6300FS电子束光刻系统能够面向纳米技术、生物技术、能源技术等,在微电子、微光学、微机械等学科领域支撑开展纳米加工、高精度掩模制造、新结构加工和新器件制备等工作;并可以在微机械加工技术、位相相移技术、计算全息编码技术、防伪技术、定位测量光栅技术等领域开展纳米加工工作。
(三)设备图片
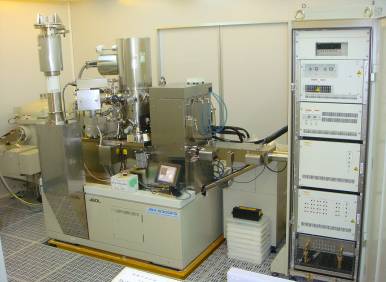
图1 :JEOL JBX6300FS电子束光刻系统主机
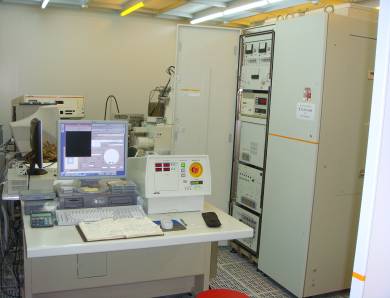
图2 :JEOL JBX6300FS电子束光刻系统控制部分
设备2:JEOL JBX 5000LS电子束光刻系统(所级实验平台)
(一)设备简介
日本电子生产的JEOL JBX 5000LS电子束光刻系统,是矢量扫描的电子束曝光机,采用热场发射阴极电子发射源,可以工作在25KV和50KV的加速电压下,可实现最小电子束束斑为8纳米,满足最小分辨率为30纳米,适用光刻线宽为90纳米,
图形套刻精度40-60纳米。
JBX-5000LS电子束光刻系统主要应用于100-500纳米尺度的纳米结构电子束直写光刻(可以延伸应用到微米级),可应用于2英寸、3英寸、4英寸、5英寸晶元片及碎片。
(二)设备应用
JEOL JBX 5000 LS电子束光刻系统可以提供以下电子束光刻技术服务及合作开展纳米技术研究:
(1)采用电子束光刻技术对外合作开展纳米加工技术研究,包括100-500纳米结构图形加工;
(2)可用于曝光线宽0.5-1微米各种特殊曲线及微结构图形;
(3)可提供线宽100-500纳米研究性芯片直接光刻技术服务,也可以采用电子束光刻系统与投影光刻机或接近/接触式光刻机匹配-混合光刻研制深亚微米器件和电路;
(4)可提供电子束曝光邻近效应校正技术(EPC)服务及图形数据处理服务。
(三)设备图片

图3 :JEOL JBX 5000LS电子束光刻系统主机及控制部分
系统3:光学制版系统
(一)设备简介
光学制版系统,配置有美国GCA 3600F Pattern Generator图形发生器、GCA 3696 Photorepeater分步重复精缩机、美国应用材料公司MEBES 4700S电子束掩模曝光系统。
其中GCA3600F图形发生器和GCA3696分步重复精缩机组成的光学曝光系统主要应用于常规1微米以上光掩模版制造,采用图形合成技术可以延伸应用到亚微米周期性强的超大面积掩模制造;MEBES-4700S电子束曝光系统主要应用于500纳米到微米以上复杂光掩模版制造和4:1投影光刻机中间掩模版制造,采用电子束抗蚀剂可以延伸应用到0.35微米掩模版制造。
(二)设备应用
光学制版系统可以提供以下技术服务:
(1)提供光学制版技术服务,包括:中间掩模版(Reticle)制作、工作掩模 (Working Mask) 或主掩模版 (Master Mask) 制作;
(2)提供电子束曝光制版技术服务,可用于制造(2.5"、3"、4"、5")掩模版/掩模版厚度0.06"--0.09"、 (4"、5"、6")掩模版/掩模版厚度0.09"--0.25";
(3)提供实验用移相掩模加工技术及光学邻近效应校正图形数据处理服务;
(4)提供特种制版技术服务,包括:线宽尺寸标定用的标准图形掩模版、各种线宽尺寸分辨率图形掩模版、光学图形合成技术制造超象场大面积高精度特殊掩模版等。
(三)设备图片

图4 :MEBES 4700S电子束掩模曝光系统主机

图5 :MEBES 4700S电子束掩模曝光系统控制部分

图6 :GCA 3600F Pattern Generator图形发生器

图7 :GCA3696分步重复精缩机
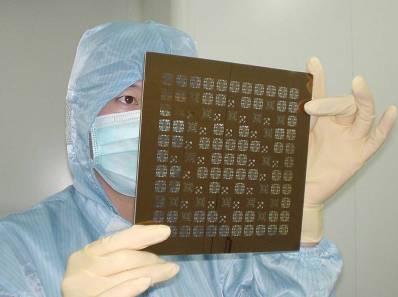
图8 :工艺人员展示光学掩模版成品

图9 :微光刻与掩模制造研发平台及电子束光刻技术工艺平台用户分布图
公共技术服务中心