近日,中国科学院微电子研究所集成电路先导工艺研发中心在22纳米 CMOS关键技术先导研发上取得突破性进展,在国内首次采用后高K工艺成功研制出包含先进的高K/金属栅模块的22纳米栅长MOSFETs,器件性能良好,达到国内领先、世界一流水平。
22 纳米 CMOS技术是全球正在研究开发的最新一代集成电路制造工艺,各国都投入了巨大资金,力争抢占技术制高点。Intel开发的基于三栅器件结构的处理器已于近期实现量产;IBM联盟也于近期发布了采用22纳米工艺生产的SRAM芯片;Global Foundries,欧洲的IMEC,日韩的三星、Toshiba和我国台湾的台积电也发布了各自的22纳米制程技术;我国于2009年在国家科技重大专项的支持下开始22纳米关键技术先导研发。作为该项目的牵头单位,中科院微电子研究所集成电路先导工艺研发中心与项目联合承担单位,北京大学、清华大学、复旦大学和中科院微系统所的项目组一道,开展了系统的联合攻关。经过3年多的辛勤努力,该项目于近期取得突破性进展。
在22纳米 CMOS技术节点,为了降低成本、减少功耗和提高器件性能,高K/金属栅技术被广泛引入,同时也对器件制造工艺及集成技术带来了很大的挑战,主要包括了以下几个方面:一是界面工程,需要研究高K材料与硅沟道的界面态特性、应力引入控制机制、影响载流子迁移率的原理机制等;二是栅工程,对高性能的NMOS和PMOS器件而言,筛选出具有合适功函数的金属栅材料及堆叠结构避免费米钉扎效应,降低刻蚀工艺及集成技术的难度至关重要;三是需要实现超浅结的源漏工程,确保器件具有良好的短沟道效应抑制特性和欧姆接触。针对上述核心问题,项目组开展了系统的研究工作,在N型和P型MOS电容上均获得了EOT≤8.5 Ǻ,漏电流降低3个数量级,金属栅有效功函数距硅带隙边距离≤0.2eV的良好电学结果。成功研制出器件性能良好的22纳米栅长MOSFET器件 (图1)。其中,NMOS和PMOS的阈值电压分别达到工业要求的0.3V 和-0.28V左右,在|Vdd|= 1V时饱和导通电流Ion (在没有使用应变硅增强技术的条件下)分别达到465µA/µm和368µA/µm,短沟道效应得到很好的改善,亚阈值摆幅(SS)和漏致势垒降低(DIBL)控制在85mV/dec和65mV以内(图2),均满足工业应用标准。
在这一过程中,中科院微电子研究所与北京大学、清华大学、复旦大学以及中科院微系统所的联合项目组完成了1369项专利申请,其中包括424项国际专利申请,为我国在集成电路领域掌握自主知识产权,取得国际话语权奠定了基础,其中后高K/金属栅工艺模块及相关专利、金属栅堆叠结构及其专利等均已开始在国内集成电路制造企业进行进一步的生产工艺开发。
多年来,我国的集成电路先进制造工艺大多是在引进的核心知识产权上进行产品工艺开发,在全球产业链最先进工艺的开发上缺少布局和话语权。此次22纳米关键技术先导研发是国内第一次在全球最先进工艺技术代组织这么大规模的产学研联合攻关,同期,国内制造企业在28纳米工艺上也在进行开发,目标就是在22纳米核心技术的知识产权中取得一席之地,在我国集成电路制造产业进入22纳米技术代时,开始拥有自己的话语权。该成果的取得对我国集成电路产业在22纳米获得具有自主知识产权的核心技术有重要意义,也为我国继续自主研发16纳米及以下技术代的关键工艺提供了必要的技术支撑。结合国内制造企业在28纳米技术研发上取得的突破,我国已开始在全球尖端集成电路技术创新链中拥有自己的地位。 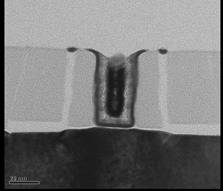
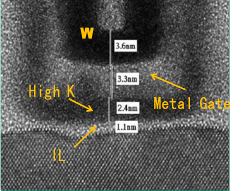
图1 22纳米 栅长NMOS截面和高K/金属栅堆叠结构的TEM照片(中科院微电子研究所,2012) 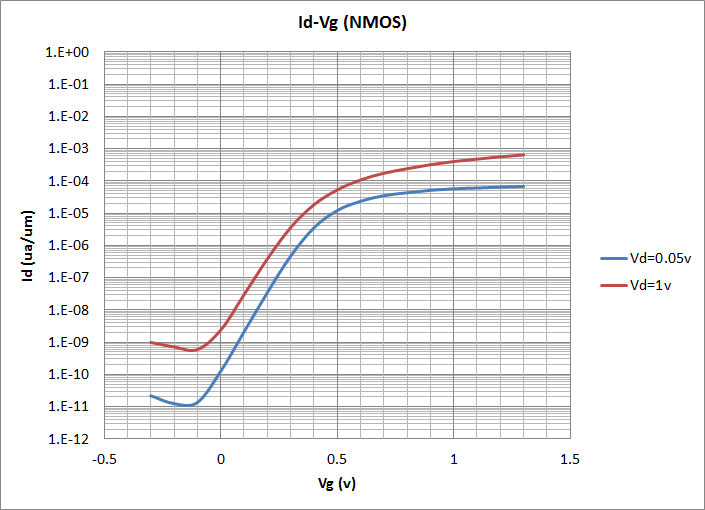
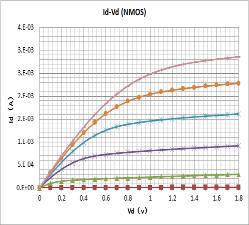
图2 NMOS的Id-Vg转移曲线以及Id-Vd输出曲线(中科院微电子研究所,2012) 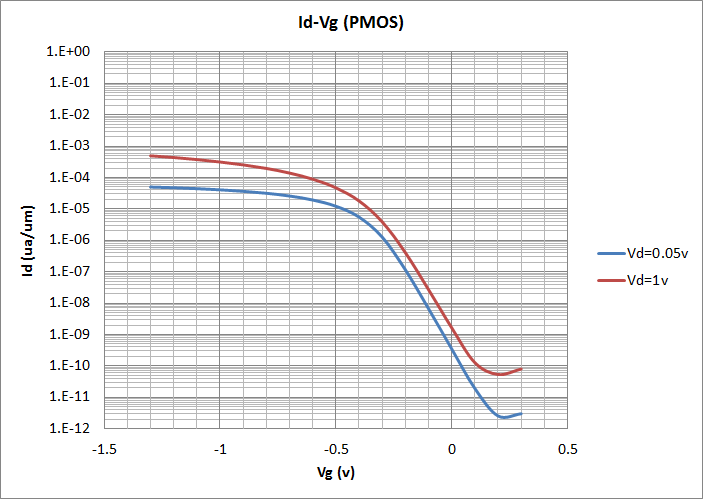
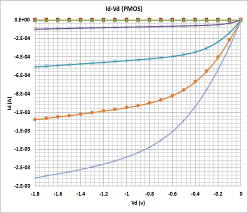
图3 PMOS的Id-Vg转移曲线以及Id-Vd输出曲线(中科院微电子研究所,2012)
m
综合信息